- 半导体封装产业应用概述
在半导体封装领域,无铅锡材(核心为无铅锡膏、无铅焊锡丝、无铅锡球、无铅锡片)是实现 “芯片与基板 / 引脚连接”“封装体密封防护”“散热传导” 的关键材料,直接决定半导体器件的电气性能、可靠性与使用寿命。其核心价值不仅是替代传统有铅锡材以满足 RoHS、JEDEC 等环保与行业标准,更需适配半导体封装的高密度、微型化(如芯片尺寸封装 CSP、系统级封装 SiP)、高功率(如车规半导体)需求。
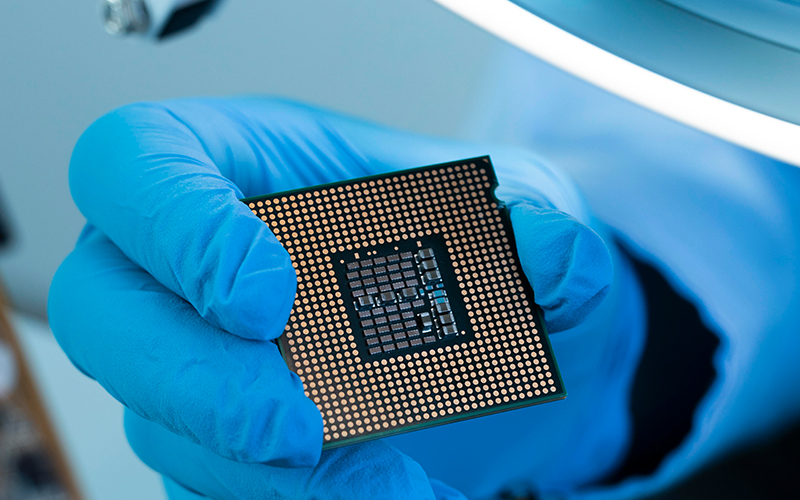
-
01
- 电气连接功能:构建芯片与外部的 “导电通路”
低阻导通:锡材本身电阻率极低,确保芯片输出的高频信号、大电流无损耗传输;
微型化连接:适配半导体封装的 “窄间距” 需求,通过精准的锡材形态(如锡球、超细锡膏)实现高密度电极的一一对应连接,避免短路。
-
02
- 结构固定与防护功能:保障芯片长期稳定
机械固定:焊点不仅导电,还需将芯片与封装基板 / 外壳牢固结合,抵抗封装过程中的应力、使用中的震动,防止芯片位移或脱落;
环境隔离:部分封装形式中,无铅锡片 / 锡膏可填充芯片与散热基板的缝隙,形成密封层,阻挡水汽、腐蚀性气体侵入芯片,避免电路氧化或短路。
-
03
- 散热传导功能:解决高功率半导体的 “热失效” 问题
热桥传导:锡材的导热系数远高于树脂等绝缘材料,可作为 “热桥” 将芯片产生的热量传递到封装外壳或散热基板,再通过散热器导出;
低热阻连接:通过锡材填充芯片与散热基板的微观缝隙,减少 “空气间隙”,降低整体热阻,提升散热效率。
应用相关产品




